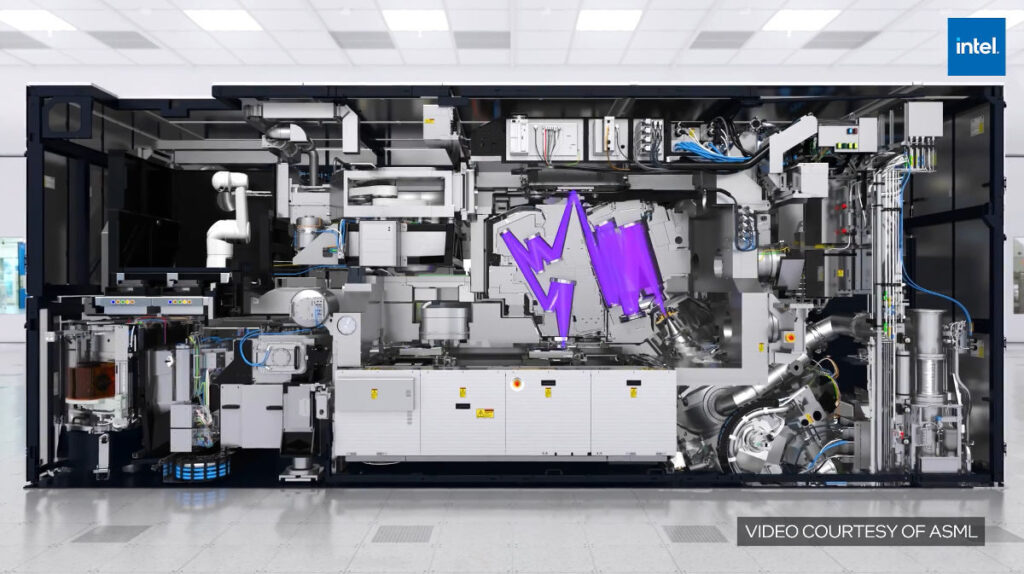
- INDEX目次
目次【非表示】
- 1.そもそも半導体製造における「露光」とは何か
- 2.EUV露光装置はどのような仕組みで動くのか
- 3.光源となるEUV(極端紫外線)の特性
- 3-1.微細な回路パターンを転写するプロセス
- 4.EUV露光技術を導入するメリット
- 4-1.これまで以上に微細な回路形成の実現
- 4-2.製造工程の簡略化による生産効率の向上
- 5.EUV露光装置が抱える技術的・コスト的な課題
- 5-1.装置の構造が複雑で開発難易度が高い
- 5-2.1台数百億円にもなる莫大な導入コスト
- 5-3.強力な光源の確保と維持の難しさ
- 6.EUV露光装置のメーカー別シェアと市場動向
- 6-1.オランダASML社が市場を独占している現状
- 6-2.日本の関連部品・素材メーカーが果たす役割
- 7.EUV露光装置の今後の開発と将来の展望
- 8.次世代機「ハイNA EUV露光装置」の開発状況
- 8-1.さらなる半導体の高性能化に向けた技術革新
- 9.まとめ
EUV露光装置は、極端紫外線と呼ばれる非常に短い波長の光を使用して、ナノメートルレベルの微細な回路パターンをシリコンウェハ上に描画できる最先端の半導体製造装置です。この技術により、何ができるかというと、従来の露光技術では困難だった7nm以下の微細な回路形成が実現し、半導体の集積度と性能を大幅に向上できるメリットがあります。スマートフォンや高性能サーバーチップ、AI専用チップなどの製造に不可欠な技術となっており、より高い処理能力と低い消費電力を実現する中核技術として、デジタル社会の進化を支えています。
そもそも半導体製造における「露光」とは何か
EUV露光装置は、最先端の半導体製造に不可欠な技術であり、極端紫外線(EUV)と呼ばれる非常に短い波長の光を使用して、ナノメートルレベルの微細な回路パターンをシリコンウェハ上に描画できます。この装置の大きなメリットは、従来の露光技術では困難だった7nm以下の微細な回路形成を実現し、半導体の集積度と性能を大幅に向上させられる点です。スマートフォンや高性能サーバーチップ、AI専用チップなどの製造に欠かせない技術となっており、より高い処理能力と低い消費電力を実現する中核技術として、デジタル社会の進化を支えています。
EUV露光装置はどのような仕組みで動くのか
EUV露光装置は、最先端の半導体製造に不可欠な装置であり、その複雑な構造と高精度な技術が特徴です。EUV露光機は、極端紫外線(EUV)という非常に短い波長の光を使用し、微細な回路パターンをシリコンウェハ上に描画します。空気中でも吸収されてしまうEUV光の特性から、装置内部は高真空状態に保たれています。
EUV露光装置の仕組みは、まずスズに炭酸ガスレーザーを照射してEUV光を生成し、これを集光ミラーで集めます。従来の露光装置がレンズを使用していたのに対し、EUV露光装置ではEUV光がレンズに吸収されてしまうため、複数枚の反射ミラーを用いて光を誘導・転写する構造になっています。 この反射ミラーは、Mo/Si多層膜ミラーと呼ばれ、高い反射率を誇ります。 光源から出たEUV光は、これらの反射ミラーとレンズのような役割を果たす投影光学系を介して、フォトマスクに描かれた回路パターンをウェハに転写するのです。
光源となるEUV(極端紫外線)の特性
EUV(極端紫外線)露光装置における光源は、波長が13.5nmと非常に短い特殊な光です。この極めて短い波長により、7nm以下の微細な回路パターン形成が可能になり、最先端の半導体製造に不可欠な技術となっています。EUV光は物質に吸収されやすい特性を持つため、露光装置内部は高真空に保たれています。
EUV光を生成するためには、まず溶融したスズ(Sn)の微細な液滴に炭酸ガスレーザーを2回照射し、約30万Kの高温プラズマを発生させます。 このプラズマから放射される光を集光器で集めることで、目的のEUV光が得られます。
EUV露光装置の稼働には、スズを数百気圧という高圧ガス状態で管理する必要があるため、日本では高圧ガス保安法の適用対象となり、装置の導入や使用において規制を受ける可能性があります。 この光源の高出力化は、露光プロセス全体の生産性を向上させる上で重要な課題であり、現在もより強力な光源技術の開発が進められています。
微細な回路パターンを転写するプロセス
EUV露光装置における回路パターンの転写プロセスは、半導体製造の精度を決定する重要な工程です。まず、EUV光はマスク(フォトマスク)と呼ばれる原版に描かれた回路パターンを透過します。このマスクには、半導体チップ上に形成されるべき微細な回路の設計図が描かれているのです。マスクを透過したEUV光は、複数の反射ミラーで構成された投影光学系によって縮小され、シリコンウェハー上に塗布された感光性のレジスト材料に照射されます。
この投影光学系は、EUV光の波長が非常に短いため、通常のレンズではなく特殊な多層膜ミラーを使用しています。ミラーは極めて高い精度で研磨されており、これによりEUV光の吸収を最小限に抑えながら、正確に回路パターンをウェハーに転写することが可能になるのです。具体的には、2nmといった極めて微細な線幅のパターンでも、高い忠実度で転写できる技術が確立されています。
レジスト材料はEUV光を浴びることで化学変化を起こし、その後の現像工程によって露光された部分が除去されたり、残ったりすることで、マスクのパターンがウェハー上に忠実に再現されます。この一連のプロセスは、ナノメートルスケールの精度が求められるため、非常に高度な技術と設備が必要とされます。
EUV露光技術を導入するメリット
EUV露光技術を導入すると、従来の露光技術では困難だった7nm以下の微細な回路パターン形成が可能になります。これにより、半導体の集積度と性能が大幅に向上し、スマートフォンや高性能コンピューターなどのデバイスの進化に貢献しています。
また、EUV露光では多重露光の必要性が少なくなるため、製造プロセスが簡素化され、生産効率が向上するメリットがあります。 これにより、単位時間当たりのウェハ処理枚数であるスループットが向上し、製造コストの低減も期待できます。
これまで以上に微細な回路形成の実現
EUV露光技術の最大のメリットは、極めて微細な回路形成が可能になる点です。EUV光は波長が13.5nmと非常に短いため、従来のArFエキシマレーザー(波長193nm)では難しかった7nm以下の回路パターンを効率的に形成できます。これにより、半導体の集積度と性能が大幅に向上し、スマートフォンや高性能コンピュータ、AI専用チップなどの進化に不可欠な技術となっています。
従来の露光技術では、微細なパターン形成のために複数回の露光が必要な「マルチパターニング」が採用されていました。しかし、EUV露光では一度の露光で微細なパターンを形成できるケースが多く、製造工程の簡略化に繋がり、生産効率の向上にも貢献しています。
また、EUV露光とは異なる技術として、ナノインプリント技術も微細な回路形成を実現する手法として注目されています。ナノインプリントは、ナノメートル単位の微細パターンが刻まれた型を対象物に押し当ててパターンを転写する加工方法であり、EUV露光に比べてシンプルな仕組みで消費電力を大幅に削減できるというメリットがあります。キヤノンやDNPなどがこの技術に取り組んでおり、将来的に2nmノードレベルの最小線幅10nmへの対応も期待されています。
製造工程の簡略化による生産効率の向上
EUV露光技術を導入することで、これまで複数回の露光工程が必要だった回路パターンの形成が、1回の露光で可能になります。従来の多重露光では、一度の露光では描ききれない微細なパターンを、複数回に分けて重ねて描いていました。このプロセスは時間とコストがかかるだけでなく、露光ごとのずれが生じるリスクもありました。しかし、EUV露光装置の採用により、シングルパターニングで同等の微細パターンを形成できるため、製造工程が大幅に簡略化されます。これにより、生産スループットの向上が期待でき、半導体メーカーはより効率的に製品を市場に投入できるようになります。例えば、東京エレクトロン(tel)のような企業が提供するリソグラフィ技術と組み合わせることで、さらに製造効率を高めることが可能です。結果として、半導体デバイスの製造コスト削減にも繋がり、最終的には高性能な半導体をより手頃な価格で消費者に提供できる可能性が高まります。
EUV露光装置が抱える技術的・コスト的な課題
EUV露光装置は、回路の微細化に不可欠な技術である一方で、いくつかの技術的・コスト的な課題を抱えています。まず、装置の構造が非常に複雑で、開発難易度が高い点が挙げられます。EUV光は物質に吸収されやすいため、装置内を高真空に保つ必要があり、さらに高精度な反射ミラーや特殊な光学系、光源技術が求められます。
EUV露光装置の導入には莫大なコストがかかります。1台あたり数百億円に達するとされており、これはEUV光源、高精度なミラーレンズ、真空システムなど、各コンポーネントが高額であるためです。 また、強力なEUV光源の確保と維持も大きな課題です。EUV光を生成するには、スズ(Sn)の液滴にレーザーを照射し、プラズマ発光させる必要がありますが、この工程で大幅な光の減衰が発生するため、高出力のレーザー光源が必要となり、装置全体の消費電力が約1メガワットと非常に大きくなります。 このため、半導体メーカーにとって、工場での電気代が高額になるという不満も上がっています。
装置の構造が複雑で開発難易度が高い
EUV露光装置は、半導体製造の最先端技術を集約したものであり、その複雑な構造が開発難易度を非常に高くしています。この装置は、極端紫外線(EUV)を用いてナノメートルレベルの微細な回路パターンをシリコンウェハ上に描画するのですが、従来の露光技術とは異なる特殊な光源や照明光学系を採用しているため、高度な精密制御技術が不可欠です。たとえば、EUV光は空気中の酸素や窒素に吸収されやすいため、装置内部全体が高真空に保たれており、その環境下で光を集め、パターンを転写するミラーは数ピコメートル(1兆分の1メートル)レベルの精度が求められます。
さらに、EUV光を生成するためのスズ(Sn)を用いたレーザープラズマ発光技術は、高出力レーザーでスズの液滴に照射して発光させるという複雑な動作を1秒間に5万回という速度で実行する必要があり、その過程でミラーがスズで汚染される問題も発生します。これらの課題を解決するためには、高精度で製造された反射ミラーやフォトマスクなどの極端な精度が求められる部品が多数必要となり、装置全体の開発には莫大な研究開発投資と長期的なコミットメントが不可欠です。
1台数百億円にもなる莫大な導入コスト
EUV露光装置は、その技術的な複雑さと製造プロセスの高度さから、導入には莫大なコストがかかります。1台あたりの価格は、数百億円に上るとされており、最先端のモデルでは500億円を超えることも珍しくありません。この高額な価格は、装置の設計、部品製造、組み立て、そして研究開発に要する膨大な投資に起因しています。特に、光源となるEUVを生成するための高出力レーザーや、精密な反射ミラー、真空環境を維持する技術など、多岐にわたる最先端技術が結集されているため、製造コストも非常に高くなります。
また、装置自体の価格だけでなく、設置や稼働には専用のクリーンルームや周辺設備、高度な専門知識を持つ技術者が必要となるため、これらを含めた総導入コストはさらに膨らむ傾向にあります。このような莫大な初期投資は、半導体メーカーにとって大きな負担となり、EUV露光装置を導入できる企業は世界でもごく限られています。このことが、半導体製造における技術格差の一因ともなっているのです。
強力な光源の確保と維持の難しさ
EUV露光装置における強力な光源の確保と維持は、技術的な課題の一つです。EUV(極端紫外線)を生成するためには、スズ(Sn)をプラズマ化させて発光させる方法が採用されており、高出力のレーザーをスズに照射し、瞬間的に高温のプラズマを生成します。このプラズマから放射される13.5nmという極めて短い波長の光がEUV光源となります。しかし、このプロセスではスズが飛び散ることでミラーが汚染されやすく、EUV光の透過率が低下するという問題があります。そのため、ミラーを常にクリーンな状態に保つための高度な技術が必要とされます。
また、EUV光は真空中でしか伝搬しないため、装置全体を真空状態に保つ必要があり、その維持には多大なコストと技術が伴います。こうした課題に対し、日本のメーカーも様々な技術で貢献しています。例えば、半導体検査装置を手掛けるレーザーテックは、EUVマスクブランクス(EUV露光用の基板)の欠陥検査装置を提供し、品質維持に貢献しています。このように、EUV露光装置の性能を最大限に引き出すためには、光源の安定的な供給と維持が不可欠であり、そのための研究開発が現在も活発に進められています。
EUV露光装置のメーカー別シェアと市場動向
EUV露光装置市場では、オランダのASML社がほぼ100%の世界シェアを占めており、これは同社が長年にわたる研究開発投資と技術革新を積み重ねてきた結果です。同社のEUV露光装置は、回路線幅7nm以下の最先端半導体製造に不可欠であり、現状ではASML社以外の企業が量産可能なEUV露光装置を供給できていません。そのため、世界中の半導体メーカーは、最先端半導体製造のためにASML社製のEUV露光装置への依存度が高い状況です。中国も半導体製造の内製化を目指していますが、EUV露光装置の調達が困難な状況にあります。このような市場動向は、今後もASML社の優位性が続くと予想されており、同社の技術動向が半導体業界全体に大きな影響を与え続けると考えられます。
オランダASML社が市場を独占している現状
現在、EUV露光装置の市場はオランダのASML社がほぼ独占している状況です。ASMLは、高性能なEUV露光装置を世界で唯一量産できるメーカーとして知られており、その技術力は世界の半導体産業を支える重要な存在となっています。同社が市場を独占する背景には、EUV露光技術の開発には莫大な投資と高度な技術が求められるため、asml以外に参入できる企業が極めて少ないという現状があります。特に、EUV露光装置は構成部品が非常に多く、30万点以上の部品を組み立てる必要があり、そのサプライチェーンも複雑です。
ASMLは長年にわたりEUV露光技術の研究開発に注力し、高出力の光源や高精度な光学系など、数々の技術的課題を克服してきました。その結果、現在では最先端の半導体メーカーにとって、ASML製のEUV露光装置が不可欠な存在となっています。特に、台湾のTSMCや韓国のサムスン電子、アメリカのインテルといった主要な半導体メーカーが、最先端のロジック半導体を製造するためにASMLのEUV露光装置を導入しています。このような市場構造は、ASMLの技術的な優位性と、新たな参入障壁の高さを示しています。
日本の関連部品・素材メーカーが果たす役割
EUV露光装置の開発競争では、かつて光学系露光装置市場を席巻していたキヤノンやニコンといった日本企業も参入していましたが、ASML社が開発を成功させたのに対し、日本企業は実用化に至らず、現在ではASML社の後塵を拝しています。この背景には、技術的な難易度の高さに加え、巨額の設備投資が必要であったこと、さらにASML社がオープンな開発体制を敷いたのに対し、日本企業が内製にこだわり過ぎたことなどが挙げられます。
しかし、EUV露光装置そのものでは苦戦を強いられている日本ですが、関連部品や素材の分野では世界的に重要な役割を担っています。例えば、EUV露光に不可欠な「レジスト」と呼ばれる感光材では、東京応化工業や信越化学工業などの日本企業が圧倒的なシェアを占めています.また、マスクの原版となる「ブランクス」はHOYAとAGC、EUVフォトマスクの欠陥検査装置はレーザーテック、塗布現像装置は東京エレクトロンがそれぞれ高いシェアを維持しており、EUV露光技術を支える上で欠かせない存在です。
これらの日本企業が提供する高精度な部品や素材は、EUV露光装置の性能を最大限に引き出し、最先端半導体製造を可能にする上で不可欠なものとなっています。
EUV露光装置の今後の開発と将来の展望
EUV露光装置は、半導体のさらなる高性能化に不可欠な技術であり、将来に向けて開発が加速しています。オランダのASML社は、次世代EUV露光装置として「ハイNA EUV露光装置」の開発を進めており、これは現在のEUV露光装置よりもレンズの開口数を大きくすることで、2nm以下のさらに微細な回路形成を可能にします。ASMLは2023年末までに試作機を出荷し、2025年には量産機の出荷を予定しています。
日本国内では、次世代半導体の国産化を目指すラピダスが、2024年中に北海道千歳市の工場にASML社製のEUV露光装置を導入し、2nm半導体の試作ラインを稼働させる予定です。 また、マイクロンは日本国内に最大5,000億円を投資し、EUV露光装置を導入して2026年頃から最先端品の生産を開始する計画です。 沖縄科学技術大学院大学(OIST)の新竹積教授は、EUV露光装置の消費電力を大幅に削減できる革新的な技術を提案しており、将来的な製造コストの低減や装置の長寿命化に貢献する可能性があります。 台湾のTSMCは、EUV露光装置の早期導入により、新竹を拠点に7nm以下の微細化プロセスを確立し、高性能半導体の製造で優位性を確立しています。 これらの取り組みは、半導体産業におけるEUV露光技術の重要性が今後も増していくことを示しています。
次世代機「ハイNA EUV露光装置」の開発状況
次世代の半導体製造を担う「ハイNA EUV露光装置」の開発が活発に進められています。この装置は、レンズのNA(開口数)を従来の0.33から0.55に拡大することで、より微細な回路パターンの形成を可能にする技術です。ASML社は、2023年末までに初の高NA EUV露光装置の試作機を出荷し、2025年には量産を開始する計画を立てています。実際に、Intel社は2023年12月にASML社から初の高NA EUV露光装置の出荷を受け、半導体製造の加速に期待を示しています。
この高NA技術によって、2nmプロセス以降のさらなる微細化が可能になります。従来のEUV露光装置ではマルチパターニング(多重露光)が必要だった微細なパターンも、高NA EUV露光装置ではシングルパターニングで形成できるようになり、製造コストの低減とスループットの向上が見込まれています。ASML社は、高NA EUV露光装置によって今後10年間以上のデバイス微細化を牽引し、解像度と重ね合わせ精度を現行のEUVプラットフォームと比較して70%向上させることを目指しています。
また、ASML社は高NA EUV露光装置に続く、NAが0.75の「Hyper-NA」EUV露光装置の開発も進めており、2030年頃の提供を目指していると発表しました。これにより、半導体のさらなる高性能化と集積化が期待されています。日本企業も、この次世代露光技術に対応するフォトレジスト材料の開発などで貢献しており、世界的な開発競争が加速しています。
さらなる半導体の高性能化に向けた技術革新
半導体業界では、EUV露光技術の進化と並行して、新たな技術革新が積極的に進められています。例えば、3次元積層技術は、単一のチップ上に複数の半導体層を積み重ねることで、データ転送速度の向上と消費電力の削減を実現するものです。これにより、限られたスペース内でより高性能な半導体を製造することが可能になります。また、新素材の研究開発も活発です。従来のシリコンに代わる新たな半導体材料や、配線材料の改良により、電子の移動速度を向上させ、さらなる性能向上を目指しています。例えば、マイクロンなどの大手メモリメーカーは、高帯域幅メモリ(HBM)のような先進的なメモリ技術の開発を進めており、これらはAIやデータセンターといった高性能コンピューティング分野において不可欠な存在となっています。これらの技術革新は、EUV露光装置によって実現される微細化と相まって、半導体のさらなる高性能化と多機能化を牽引し、未来のデジタル社会を支える基盤となることが期待されています。
まとめ
EUV露光技術は、半導体の微細化を可能にし、スマートフォンやAIチップなどの高性能デバイスの製造に不可欠な最先端技術です。EUV(極端紫外線)とは波長13.5nmという極めて短い波長の光であり、従来の露光技術では困難だった7nm以下の微細な回路パターンの形成を実現します。この技術は、高解像度化や製造工程の簡略化による生産効率の向上といったメリットをもたらします。
しかし、EUV露光装置は構造が複雑で開発難易度が高く、1台数百億円にもなる莫大な導入コストや、強力な光源の確保と維持の難しさといった技術的・コスト的な課題も抱えています。 現在、EUV露光装置市場はオランダのASML社がほぼ独占しており、次世代機である「ハイNA EUV露光装置」の開発も進められています。 日本の企業も、EUV露光に関連する部品や材料の供給において重要な役割を果たしており、今後の技術革新と国際競争の中でその役割はさらに注目されるでしょう。

西進商事コラム編集部
西進商事コラム編集部
西進商事コラム編集部です。専門商社かつメーカーとしての長い歴史を持ち、精密装置やレーザー加工の最前線を発信。分析標準物質の活用も含め、さまざまなコラム発信をします。

アングストローム技術とは?オングストローム時代の半導体の仕組み

エキシマレーザとは?用途や特徴・仕組みについて解説

ファウンドリとは?半導体業界での役割やOSATとの違い、メリットを解説

ファイバーレーザーとは?発振原理や構成をわかりやすく解説

